Студентам > Курсовые > Развитие технологии МОП ИС
Развитие технологии МОП ИССтраница: 6/7
Рисунок 5.2 - Уменьшение глубины залегания p-n-переходов LDD-областей истока и стока с развитием технологии
Для снижения емкостей транзистора выбирают слаболегированную подложку, а для обеспечения необходимого порогового напряжения и снижения напряжения прокола применяют легирование канала примесью того же типа, что и в подложке. Легирование выполняют примерно на глубину области пространственного заряда под затвором.
Контакты к областям истока, стока и к поликремниевому затвору выполняют с промежуточным формированием слоя TiSi2 или CoSi2 толщиной порядка 40 нм, что обеспечивает удельное сопротивление около 5 Ом на квадрат. Изоляция между поликремниевым затвором и контактами к истоку и стоку выполняется в виде спейсера (разграничителя) (рис. 5.1) из Si3N4.
Концентрация примеси в канале составляет  . Увеличение концентрации примеси свыше этого значения, необходимое для транзисторов с длиной канала менее 100 нм, ведёт к появлению туннелирования электронов через р - n - переходы истока и стока. . Увеличение концентрации примеси свыше этого значения, необходимое для транзисторов с длиной канала менее 100 нм, ведёт к появлению туннелирования электронов через р - n - переходы истока и стока.
Толщина окисла для транзисторов с длиной канала 0,1 мкм составляет 3–4 нм. Между толщиной окисла tox и длиной канала L МОП – транзисторов, изготавливаемых фирмой Intel в течение последних 20 лет, существует эмпирическая зависимость L = 45·tox.
Для формирования карманов МОП - транзисторов разного типа проводимости (рис. 5.3) используют фосфор и бор. Изоляцию между карманами выполняют обычно мелкими канавками, стенки которых окисляют, а внутренность заполняют поликремнием. Эта технология изоляции стала доминирующей в транзисторах, выполненных по 0,25-микронной технологии и пришла на смену изоляции локальным окислением кремния (LOCOS).
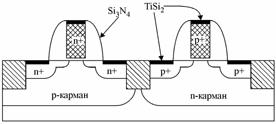
Рисунок 5.3 - Комплиментарная пара транзисторов, использованная в 0,25-мкм техпроцессе при производстве микропроцессоров Intel® Celeron и Pentium® II
5.2 Методы улучшения характеристик МОП - транзисторов
Уменьшение порогового напряжения при снижении длины канала является индикатором появления короткоканальных эффектов при разработке новых технологий и одновременно существенным препятствием на пути сокращения размеров транзисторных структур. Для борьбы с эффектами короткого канала используется изменение профиля легирующей примеси как в горизонтальном, так и в вертикальном направлении. В горизонтальном направлении (вдоль канала) создают ореол (halo) вокруг слаболегированных областей истока и стока (рис. 5.1), выполняют ионную имплантацию в кармашки (pockets). В вертикальном направлении создают неоднородное (ретроградное) распределение примеси, экстремально мелкие области истока и стока, применяют новые материалы с большей, чем у окиси кремния, диэлектрической проницаемостью.
Проникновение области обеднения стока в канал является основной причиной появления короткоканальных эффектов. Однако их нельзя устранить путём простого повышения концентрации легирующей примеси в подложке, поскольку при этом растёт подпороговый ток и уменьшается подвижность носителей в канале, вызывающая деградацию нагрузочной способности транзистора. Наиболее распространённым решением этой проблемы является реализация так называемого обратного эффекта короткого канала, когда с уменьшением длины канала пороговое напряжение возрастает. Этого можно достичь применением ореола (halo) вокруг областей истока и стока (рис. 5.1).
Ореол создаётся ионным легированием примеси того же типа проводимости, что и карман (бор или индий для n-канального транзистора и мышьяк для p-канального). Индий, по сравнению с бором, снижает крутизну падения порогового напряжения, в зависимости от длины канала, и уменьшает разброс наклона подпороговой характеристики. Ионное легирование может выполняться вертикально, но чаще под углом, для чего кремниевую пластину наклоняют на угол от 20–30 до 90 град. по отношению к ионному пучку, чтобы направить его под затвор. Ореол делают обычно на том же этапе литографии, что и мелкие слаболегированные области истока и стока. Энергию имплантации выбирают достаточно большую, чтобы увеличить глубину залегания ореола. После формирования спейсера, во время отжига областей истока и стока, имплантант диффундирует за LDD-области, обеспечивая показанный на рис. 5.4 профиль распределения примеси. 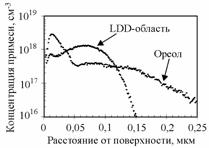
Рисунок 5.4 - Профиль примеси в области ореола и слаболегированной (LDD) области истока или стока для 0,25-мкм технологии
 Принцип действия ореола основан на том, что пороговое напряжение МОП - транзистора зависит от средней концентрации примеси под затвором, а не от её горизонтального распределения. Поэтому введение ореола увеличивает пороговое напряжение, однако практически не влияет на среднюю подвижность носителей в канале. Ионное легирование в кармашек (pocket) отличается от ореола только тем, что охватывает не всю LDD-область, а только её часть у поверхности или снизу (рис. 5.5). Принцип действия ореола основан на том, что пороговое напряжение МОП - транзистора зависит от средней концентрации примеси под затвором, а не от её горизонтального распределения. Поэтому введение ореола увеличивает пороговое напряжение, однако практически не влияет на среднюю подвижность носителей в канале. Ионное легирование в кармашек (pocket) отличается от ореола только тем, что охватывает не всю LDD-область, а только её часть у поверхности или снизу (рис. 5.5).
Рисунок 5.5. Крутое ретроградное распределение примеси в кармане (SSRW)
Крутое ретроградное распределение примеси (Super Steep Retrograde Well, SSRW) (рис. 5.5) создаётся путём медленной диффузии мышьяка или сурьмы для р - канальных приборов и индия для n-канальных. Благодаря возможности устанавливать поверхностную концентрацию легирующей примеси независимо от объёмной, появляется дополнительная степень свободы для независимой регулировки порогового напряжения и концентрации примеси в подложке, влияющей на величину области пространственного заряда и, соответственно, короанальные эффекты. Правильное применение идеи SSRW позволяет ослабить влияние короткоканальных эффектов и увеличить поверхностную подвижность носителей, однако при этом несколько увеличивается подпороговый ток.
Сравнение структур с однородным и ретроградным распределением примеси достаточно неоднозначно из-за сложности выбора условий сравнения и иногда даёт противоречивые результаты. Разновидностью крутого ретроградного распределения примеси является дельта-легирование подложки, имеющее аналогичные свойства.
Одним из путей увеличения передаточной проводимости и нагрузочной способности МОП - транзистора является уменьшение толщины подзатворного окисла. Толщина окисла ограничивается появлением паразитного туннельного тока, который увеличивает энергопотребление микросхемы, и нестабильностью напряжения пробоя окисла, снижающей надёжность.
Экспериментально показана возможность уменьшения толщины подзатворного диэлектрика до 1,5 нм. В эксперименте длина канала составляла около 0,1 мкм, при этом нагрузочная способность транзистора была равна 1 мА/мкм, передаточная проводимость — 1000 мСим/мм при комнатной температуре.
Рост туннельного тока через окисел является не единственной преградой на пути уменьшения его толщины. В экспериментах с приборами, имеющими толщину затвора 1,2–2,8 нм, было показано, что с ростом туннельного тока увеличивается статистический разброс порогового напряжения. Это объясняется тем, что пороговое напряжение начинает зависеть от падения напряжения на омическом сопротивлении затвора; падение напряжения вызывается прохождением туннельного тока. При этом в разброс порогового напряжения вносится компонента, связанная с разбросом сопротивления затвора.
| 
 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50

 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50