Студентам > Курсовые > Развитие технологии МОП ИС
Развитие технологии МОП ИССтраница: 3/7
Процесс локального окисления аналогичен процессу, используемому для изоляции биполярных транзисторов, за исключением того, что при изоляции МОП ПТ локальный окисел не должен пронизывать всю толщину эпитаксиального слоя. Наряду с хорошими изолирующими свойствами, достоинством LOCOS-метода является преимущественное заглубление окисла в подложку, так что поверхность остается почти плоской (это важно при проведении процессов фотолитографии). В дополнение, для более эффективной изоляции методом LOCOS можно формировать области, ограничивающие распространение инверсного канала (рис. 3.2). Доза имплантации при легировании ограничительных областей обычно составляет  ; энергия имплантации выбирается достаточной для глубокого проникновения примеси с учетом частичного окисления слоя. ; энергия имплантации выбирается достаточной для глубокого проникновения примеси с учетом частичного окисления слоя.
3.3 Легирование области канала
Обычно проводится для регулировки величины порогового напряжения МОП ПТ. В зависимости от режима работы транзистора имплантируют ионы бора или фосфора. Для получения транзисторов, работающих в режиме обеднения, имплантируют ионы фосфора (n-канал), для режима обогащения - ионы бора (р - канал). Имплантацию проводят через тонкий слой окисла (рис. 3.3). Дозу и энергию имплантации выбирают, исходя из требуемой величины порогового напряжения с учетом толщины окисла. В связи с тенденцией уменьшения длины канала в технологии СБИС применяют более глубокую имплантацию ионов с большей дозой (или двухстадийную имплантацию с различными дозами и энергиями): это позволяет избежать перекрытия обедненных исток - стоковых областей.
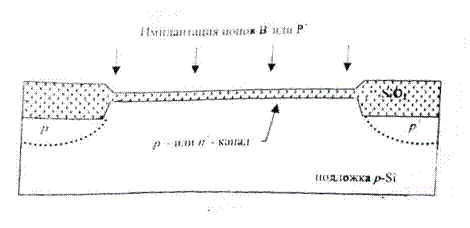
Рисунок 3.3 – Легирование области канала для регулировки величины порогового напряжения МОП ПТ
Вместе с тем увеличение концентрации примеси в области канала приводит и к нежелательным последствиям, т. к. сопровождается уменьшением подвижности носителей заряда.
3.4 Формирование затвора
Производят путем осаждения поликристаллического кремния (поли-Si) в соответствующую область транзистора, при этом при осаждении поли-Si легируют фосфором до высокой концентрации носителей. Выбор поли – Si обусловлен его способностью хорошо выдерживать высокотемпературную термообработку, а также одинаковой величиной работы выхода, что упрощает регулировку пороговых напряжений МОП ПТ. Вместе с тем сопротивление поли Si (>10 Ом) достаточно велико, что может приводить к значительной задержке сигнала, проходящего по таким шинам, особенно при большой их длине (например, общая шина для большого количества МОП – транзисторов). Поэтому в последнее время формируют многослойные затворы с применением слоёв силицидов тугоплавких металлов (рис. 3.4). Многослойный полицидный затвор имеет низкое слоевое сопротивление при сохранении электронных свойств границы раздела поли Si – SiO2. Области истока и стока формируют высокодозной имплантацией ионов As в условиях их самосовмещения с каналом; при этом слои LOCOS – изоляции и затвора играют роль маскирующего покрытия, которое обеспечивает локальность легирования. 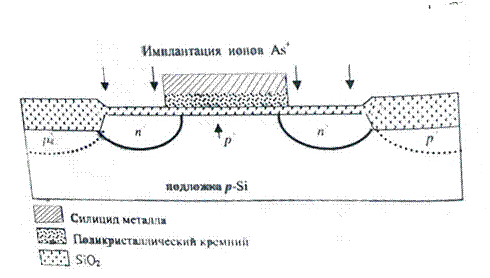
Рисунок 3.4 – Формирование двухслойного затвора и исток – стоковых областей МОП – полевого транзистора
К преимуществам метода, при котором используется нанесение силицидов на поверхность легированного поли – Si (такая структура называется полицид), относится снижение поверхностного сопротивления до 1-3  при сохранении хорошо изученной границы раздела поли Si – SiO2. при сохранении хорошо изученной границы раздела поли Si – SiO2.
3.5 Формирование областей истока и стока.
Для создания исток - стоковых областей более других подходит мышьяк, который позволяет получать мелкие p-n-переходы с минимальной диффузией в горизонтальном направлении. Доза имплантируемой примеси обычно достаточно высока и лежит в диапазоне  , что обеспечивает формирование низкоомных областей истока и стока. Энергия имплантируемых ионов должна быть достаточно высокой, чтобы они смогли проникнуть через пленку подзатворного окисла (см. рис. 3.4), но в то же время достаточно низкой для предотвращения их проникновения через пленку поликремния и области локального окисления. Формируемые таким образом области истока и стока самосовмещаются с затвором. Такое самосовмещение способствует минимизации перекрытия затвора с областями истока и стока, из которых примесь диффундирует в поперечном направлении. Тем самым обеспечивается снижение емкостей связи. После легирования областей истока и стока проводят отжиг имплантационных дефектов, для которого используют окисляющую среду. При этом, наряду с отжигом дефектов и электрической активацией примеси, происходит рост термического окисла, в том числе на поверхности и боковых стенках поликремневого затвора. Слой окисла служит для электрической изоляции исток -стоковых областей от затвора, а также для защиты областей истока и стока от проникновения фосфора из осаждаемого на последующих стадиях фосфорно - силикатного стекла. , что обеспечивает формирование низкоомных областей истока и стока. Энергия имплантируемых ионов должна быть достаточно высокой, чтобы они смогли проникнуть через пленку подзатворного окисла (см. рис. 3.4), но в то же время достаточно низкой для предотвращения их проникновения через пленку поликремния и области локального окисления. Формируемые таким образом области истока и стока самосовмещаются с затвором. Такое самосовмещение способствует минимизации перекрытия затвора с областями истока и стока, из которых примесь диффундирует в поперечном направлении. Тем самым обеспечивается снижение емкостей связи. После легирования областей истока и стока проводят отжиг имплантационных дефектов, для которого используют окисляющую среду. При этом, наряду с отжигом дефектов и электрической активацией примеси, происходит рост термического окисла, в том числе на поверхности и боковых стенках поликремневого затвора. Слой окисла служит для электрической изоляции исток -стоковых областей от затвора, а также для защиты областей истока и стока от проникновения фосфора из осаждаемого на последующих стадиях фосфорно - силикатного стекла.
3.6 Нанесение и оплавление фосфорно-силикатного стекла (ФСС)
Слой ФСС получают осаждением окисла из парогазовой смеси (методом CVD или LPCVD) с одновременным легированием фосфором до концентрации 6-8 ат %. При таких концентрациях фосфора окисел приобретает свойство размягчаться вплоть до оплавления при его нагреве до температуры 1000-1100 °С (при меньшей концентрации процесс растекания затруднен, а концентрация фосфора выше 8 ат % может вызвать коррозию алюминиевой металлизации кислотными продуктами реакции фосфора с атмосферной влагой).
В интегральных схемах фосфорно-силикатное стекло выполняет несколько функций. Фосфор в таком стекле защищает лежащую под ним структуру прибора от подвижных ионов (Na+) и, кроме того, он делает стекло вязким, облегчая его оплавление при повышенной температуре (этот высокотемпературный процесс может быть также использован для дополнительного активирования и разгонки примеси, имплантированной в области истока и стока). Оплавление фосфорно силикатного стекла сглаживает рельеф, что улучшает воспроизведение ступенчатого рельефа при его покрытии металлической плёнкой и способствует облегчению формирования топологического рисунка слоя металлизации. Наконец, слой ФСС изолирует металлический слой от поликремниевых шин.
Для создания контакта между ними в слое ФСС вскрывают окна, после чего для сглаживания крутых боковых стенок окон проводят повторное оплавление ФСС: такие структуры пригодны для нанесения металлизации.
3.7 Металлизация
На последнем этапе проводят осаждение металлического слоя для изготовления контактов к областям истока, стока и затвора, а также межэлементных проводящих соединений внутри интегральных схем. При этом контакт к слою поликристаллического кремния обычно выполняют вне активных областей транзистора. Это связано с тем, что за счёт быстрой диффузии алюминия через слой поликристаллического кремния (диффузия по границам зёрен, усиленная электрическим полем в области контакта) атомы алюминия могут достигать слоя подзатворного диэлектрика и приводить к частичному раскислению SiO2. Слой подзатворного диэлектрика делают обычно тонким, поэтому даже небольшое его повреждение приводит к существенному изменению характеристик МОП – полевых транзисторов, вплоть до их полного повреждения.
| 
 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50

 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50