Студентам > Курсовые > Развитие технологии МОП ИС
Развитие технологии МОП ИССтраница: 5/7
На заключительных этапах формирования КМОП СБИС производят осаждение на поверхность фосфорно-силикатного стекла и его плавление при высокой температуре. После вскрытия окон в слое ФСС формируют металлизацию. Наконец, самым последним слоем наносят слой плазмохимического нитрида кремния, который обеспечивает герметизацию приборов и их защиту от механических повреждений [2, 5].
5 Особенности субмикронных МОП – транзисторов
Традиционная структура МОП - транзистора обеспечила снижение длины затвора от 10 мкм в 70-х годах до 0,06 мкм в настоящее время путём простого масштабирования, то есть уменьшением длины затвора, толщины диэлектрика и глубины залегания p-n-переходов. Однако переход проектных норм через границу 130 нм в рамках традиционной конструкции наталкивается на физические ограничения. Таким образом, транзисторы для технологий XXI века должны иметь иную структуру и использовать новые материалы для подзатворного диэлектрика.
Таблица 5.2. Ограничения дальнейшей миниатюризации
Характеристики Предел Причина ограничения
Толщина окисла 2,3 нм Туннелирование через окисел
Глубина p-n-переходов 30 нм Сопротивление областей истока и стока Легирование канала Vt = 0,25 В* Подпороговый ток
Мелкие области истока и стока 15 нм Сопротивление
Длина канала 60 нм Подпороговый ток
Длина затвора 100 нм Подпороговый ток
*) Vt - пороговое напряжение.
С уменьшением геометрических размеров транзисторов снижается площадь кристалла, уменьшаются паразитные ёмкости, улучшается быстродействие и снижается энергопотребление СБИС. За последние 30 лет длина затвора МОП -транзистора уменьшилась в 200 раз (с 10 мкм в начале 70-х годов до 60 нм в наши дни). В настоящее время коммерчески доступной является технология с минимальными горизонтальными размерами элементов 0,13 мкм, позволившая реализовать массовое производство микропроцессоров Intel Pentium 4 с тактовой частотой более 2,5 ГГц на МОП - транзисторах с длиной канала 60 нм и толщиной подзатворного окисла 1,5 нм. В соответствии с прогнозами Ассоциации предприятий полупроводниковой индустрии NTRS, минимальные размеры элементов будут продолжать быстро уменьшаться и к 2012 году достигнут 50 нм.
Каждый технологический шаг в направлении уменьшения размеров сопряжён с ростом проблем конструирования и производства, которые приходится решать для обеспечения теоретически прогнозируемых характеристик транзистора. Любое улучшение одних параметров приводит к ухудшению других, причём с уменьшением размеров взаимное влияние параметров становится всё более сильным.
С ростом степени интеграции СБИС и систем на кристалле увеличивается доля чипов, содержащих аналоговые блоки, которые обеспечивают взаимодействие с окружающим миром, необходимое для крупных и функционально законченных систем. К транзисторам для аналоговых и цифровых применений предъявляются противоречивые требования. Для цифровых СБИС пороговое напряжение нельзя снижать неограниченно, поскольку при этом увеличивается подпороговый ток, который определяет потребление энергии СБИС в неактивном состоянии. Верхний предел порогового напряжения ограничивается четвертью от напряжения питания, которое стараются снизить для уменьшения потребляемой мощности. Однако для аналоговых схем идеальным является нулевое пороговое напряжение Vt = 0, что увеличивает динамический диапазон аналоговой схемы, определяемый разностью между напряжением на затворе и Vt, то есть (Vgs – Vt).
Особыми требованиями к "аналоговым" транзисторам являются также повышенная нагрузочная способность (ток стока в режиме насыщения), линейность и малые нелинейные искажения на малом сигнале. Для дифференциальных каскадов и токового зеркала важна согласованность характеристик транзисторов.
Основными проблемами микроминиатюризации МОП - транзисторов являются туннелирование через затвор, инжекция горячих носителей в окисел, прокол между истоком и стоком, утечки в подпороговой области, уменьшение подвижности носителей в канале, увеличение последовательного сопротивления между истоком и стоком, обеспечение запаса между пороговым напряжением и напряжением питания. Транзистор должен иметь слабую зависимость порогового напряжения от напряжения на стоке, от длины и ширины канала, а также большую передаточную проводимость, большое выходное сопротивление, малое сопротивления областей истока и стока и большую нагрузочную способность. Емкости затвора и p-n-переходов должны быть минимальны. Разброс параметров техпроцесса, который растёт с уменьшением размеров транзистора, не должен снижать процент выхода годных кристаллов.
5.1 Конструкции МОП - транзисторов в СБИС
Наиболее распространённой конструкцией МОП - транзистора, используемой более 10 лет в полупроводниковой промышленности, является LDD (Lightly Doped Drain) структура (рисyнок 5.1). Её особенностью является наличие мелких слаболегированных областей, которые удлиняют области истока и стока в сторону канала. Концентрацию легирующей примеси в этих областях (фосфор и бор) и режим её разгонки выбирают таким образом, чтобы получить плавный p-n-переход. Обычно концентрация примеси составляет от  до до  , в то время как в n± областях она достигает , в то время как в n± областях она достигает – –  . Полученное таким способом снижение напряжённости электрического поля в канале на границе со стоком уменьшает энергию горячих электронов, которые вызывают долговременную деградацию параметров транзистора. . Полученное таким способом снижение напряжённости электрического поля в канале на границе со стоком уменьшает энергию горячих электронов, которые вызывают долговременную деградацию параметров транзистора. 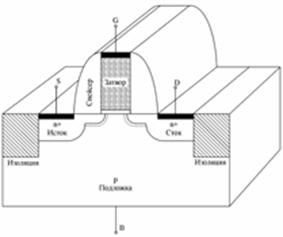
Рисунок 5.1 - Типовая структура МОП - транзистора. Пунктиром показан ореол (halo), охватывающий LDD-области истока и стока
Слаболегированные LDD-области также повышают напряжение прокола, инжекционного и лавинного пробоя транзистора, уменьшают DIBL-эффект и эффект модуляции длины канала.
Глубина LDD-областей истока и стока составляет 50–100 нм для транзисторов с длиной канала 0,25 мкм (рис. 5.2, табл. 5.1). Уменьшение глубины p-n-переходов до 10 нм приводит к увеличению сопротивления слоёв истока и стока до 10 кОм/квадрат, что ограничивает нагрузочную способность транзистора. Перекрытие LDD-областей затвором должно быть не менее 15–20 нм, чтобы предотвратить снижение нагрузочной способности транзистора. Толщина поликремниевого затвора составляет порядка 300 нм.
Таблица 5.1 Масштабирование МОП - транзисторов согласно NTRS
Проектные нормы, нм 250 180 130 100 70
Толщина окисла, нм 4–5 3–4 2–3 1,5–2 <1,5
Глубина p-n-переходов, нм 50–100 36–72 26–52 20–40 15–30
Напряжение питания, В 1,8–2,5 1,5–1,8 1,2–1,5 0,9–1,2 0,6–0,9
Ток утечки, нА/мкм 1 1 3 3 10
Нагруз. способн., мА/мкм 600/280 600/280 600/280 600/280 600/280 Мощность/кристалл, Вт 70 93 121 120 114

| 
 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50

 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50