Студентам > Курсовые > Развитие технологии МОП ИС
Развитие технологии МОП ИССтраница: 4/7
Для металлизации используют преимущественно алюминий (чистый или в сочетании с другими металлами – например, добавление меди в алюминий уменьшает вероятность электромиграции и связанных с этим эффектом обрывов металлических дорожек). Существенное уменьшение контактного сопротивление может быть достигнуто применением плёнок платины или вольфрама. В частности, при отжиге структуры плёнка платины – кремний (поликремний) формируется слой силицида платины, который позволяет снижать поверхностное сопротивление областей истока, стока и затвора с 50 до 3  , что является особенно важным для СБИС с высокой степенью интеграции. Последним на поверхность подложки осаждают сплошной слой плазмохимического нитрида кремния (SiN), который герметизирует подложку и предохраняет её от загрязнений и механических повреждений. В тех местах, где необходимо сделать внешние (проволочные) выводы к слою металлизации, в защитном покрытии встраивают контактные окна [2]. , что является особенно важным для СБИС с высокой степенью интеграции. Последним на поверхность подложки осаждают сплошной слой плазмохимического нитрида кремния (SiN), который герметизирует подложку и предохраняет её от загрязнений и механических повреждений. В тех местах, где необходимо сделать внешние (проволочные) выводы к слою металлизации, в защитном покрытии встраивают контактные окна [2].
4 Особенности технологии КМОП БИС
Технология комплементарных МОП - структур (КМОП) является в настоящее время одной из самых распространенных технологий СБИС. Технология КМОП заключается в формировании n- и р - канальных МОП - транзисторов в одном кристалле и по сравнению с n-канальными МОП ИС они потребляют значительно меньшую мощность. Особенностью технологии КМОП ИС является формирование на пластине кремния больших областей с типом проводимости, отличающимся от типа проводимости подложки. Такие области с другим типом проводимости называются карманами. В настоящее время существуют технологии с р - карманами (на пластинах n-типа проводимости), с n-карманами (на пластинах р - типа) и с n-и р - карманами (на почти компенсированном кремнии); примеры таких КМОП-структур приведены на рисунке 4.1. Недостатком интегральных схем с одним карманом является необходимость перекомпенсации, т. е. введения примеси с противоположным типом проводимости в концентрации, позволяющей изменить тип проводимости кремния. Для уверенной перекомпенсации и, следовательно, малого разброса параметров по пластине, концентрация примеси в кармане должна быть в 5-10 раз выше, чем в основной пластине. Как следствие, возникают нежелательные эффекты (увеличение обратного смещения, увеличение емкости между областями истока-стока и карманом). Технология с двумя отдельными карманами (рисунок 4.1 в) свободна от этих недостатков, однако требует подложек кремния с очень низким уровнем легирования n - Si ( -типа) или p - Si ( -типа) или p - Si ( -типа). В этих случаях, возможно, получать профили и уровни легирования в каждом кармане независимо. За исключением процедуры изготовления карманов, а также некоторых особенностей регулировки пороговых напряжений, синтеза изоляции и активных областей, при формировании КМОП СБИС используются те же технологические процессы (в сходных технологических режимах), как и в случае n-МОП. -типа). В этих случаях, возможно, получать профили и уровни легирования в каждом кармане независимо. За исключением процедуры изготовления карманов, а также некоторых особенностей регулировки пороговых напряжений, синтеза изоляции и активных областей, при формировании КМОП СБИС используются те же технологические процессы (в сходных технологических режимах), как и в случае n-МОП.
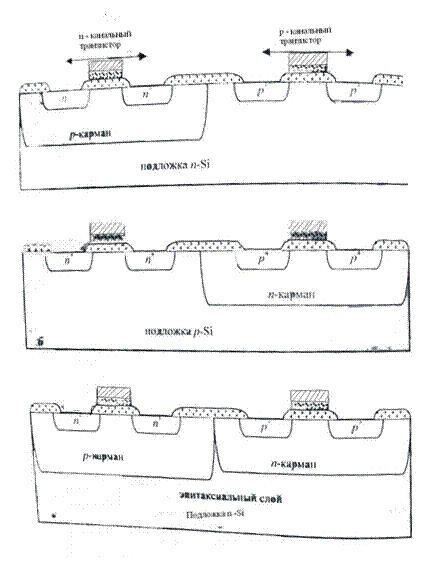
Рисунок 4.1 – КМОП-структуры с p- каналом (а), n – каналом (б), двойным карманом (в)
На рисунке 4.2 показаны этапы технологии изготовления КМОП структур. Далее описаны более подробно каждый из этапов.
1. Исходный материал - слаболегированный эпитаксиальный слой  - типа, выращенный на сильнолегированной n+ - подложке. Такая структура в сочетании с соответствующим методом формирования элементов позволяет избежать так называемого эффекта защелкивания (тиристорного эффекта). - типа, выращенный на сильнолегированной n+ - подложке. Такая структура в сочетании с соответствующим методом формирования элементов позволяет избежать так называемого эффекта защелкивания (тиристорного эффекта).
2. Формирование n и р - карманов проводят по варианту самосовмещения. На поверхность пластины наносят двухслойную плёнку SiO2 + Si3N4, в которой путём фотолитографии вытравливают области n – кармана, после чего проводят имплантацию ионов фосфора с энергией, достаточной для легирования, но недостаточной для прохождения через плёнку SiO2+Si3N4.

Рисунок 4.2 - Схема изготовления КМОП-ИМ на одной пластине с р - карманами: а - термическое оксидирование, первая фотолитография; б — локальная диффузия: в - вторая фотолитография; г — локальная диффузия; д — третья фотолитография: е — локальная диффузия; ж — четвертая фотолитография; з — выращивание тонкого подзатворного оксида и пятая фотолитография; и — формирование затворов и металлизации
При постимплантационном термическом окислении n - кармана на поверхности открытых областей происходит рост окисла, тогда как остальная часть подложки, защищённая слоем Si3N4, не окисляется. Затем методом селективного травления удаляют слой Si3N4 и во вновь открытых областях подложки формируют p - карман имплантацией ионов бора. Бор проникает в подложку через тонкую пленку Si02, в то время как области n-карманов защищены более толстым слоем окисла. После имплантации весь окисел удаляют и проводят диффузионную разгонку примеси в карманах.
3. Для изоляции транзисторов в КМОП - технологии можно использовать метод LOCOS, однако особенностью является необходимость изоляции двух различных типов транзисторов, локализованных в различных карманах вблизи границы их соприкосновения. Для того, чтобы удержать пороговые напряжения возникающих при этом паразитных транзисторов на высоком уровне, необходимо размещать n - и р - канальные транзисторы довольно далеко от границы кармана.
4. Особенностью регулировки порогового напряжения в КМОП - технологии является то, что величина Um должна быть почти одинаковой для обоих типов транзисторов и составлять менее 1 В. Однако если для различных транзисторов использовать затвор одного типа (высоколегированный поликристаллический кремний  -типа), то разность работ выхода электронов будет отличаться для р- и n-канальных транзисторов, что приводит к асимметрии пороговых напряжений обоих типов транзисторов. Подлегирование бором канала в р - кармане уменьшает величину Uпор. Наоборот, подлегирование бором канала в n - канальном транзисторе увеличивает величину Uпор. Таким образом при соответствующем выборе уровня легирования р - и n - областей можно использовать только один неселективный (без дополнительной фотолитографии) процесс ионной имплантации бора для управления (сближения) величин Uпор каждого типа транзистора. -типа), то разность работ выхода электронов будет отличаться для р- и n-канальных транзисторов, что приводит к асимметрии пороговых напряжений обоих типов транзисторов. Подлегирование бором канала в р - кармане уменьшает величину Uпор. Наоборот, подлегирование бором канала в n - канальном транзисторе увеличивает величину Uпор. Таким образом при соответствующем выборе уровня легирования р - и n - областей можно использовать только один неселективный (без дополнительной фотолитографии) процесс ионной имплантации бора для управления (сближения) величин Uпор каждого типа транзистора.
На последующих этапах проводят осаждение n+ - поликремния и формирование затворов.
5. Ионная имплантация областей истока и стока. Для уменьшения числа фотолитографий сначала проводят имплантацию бора без маскирования в истоки и стоки как n -, так и р - канальных транзисторов.
Затем локально, после проведения фотолитографии, выполняют ионную имплантацию фосфора в области истока и стока n - канальных транзисторов с более высокой дозой, достаточной для перекомпенсации находящегося там бора.
| 
 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50

 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50