Студентам > Курсовые > Вторично-ионная масса спектрометрия
Вторично-ионная масса спектрометрияСтраница: 5/5
Кроме
того, уширение или уменьшение крутизны, профиля концентрации может
происходить из-за диффузии элементов, вызываемой или усиливаемой
радиационными повреждениями в твердом теле, локальным повышением
температуры в облучаемой области и сильным электрическим полем,
возникающим в результате зарядки поверхности первичным пучком. В общем
случае роль всех этик факторов предсказать трудно. Что же касается
напряженности поля, то в пленке толщиной 1000 А при зарядке поверхности
до 10 В она может достигать 106 В/см.
Одной
однородности плотности первичного ионного тока по поверхности недостаточно
для того, чтобы травление образца протекало равномерно. Скорость травления
определяется топографией поверхности, чистотой и однородностью образца, что
в свою очередь зависит от его состава, физического состояния и
кристаллографической ориентации. Как правило, при контролируемых условиях
работы установки и состояния образца уширение профиля, связанное с
процессом ионного травления, не превышает 10% исследуемой глубины.
Внедренные
первичные ионы и вызванные ими повреждения решетки мишени могут повлиять на
форму профиля концентрации, оказав влияние на коэффициент распыления и
вероятность ионизации распыленных частиц. Но если ионное травление
осуществляется частицами с энергией 100 эВ/ат. ед. массы, то изменения матрицы
вследствие внедрения ионов ограничены поверхностным слоем толщиной 100 А. За
его пределами концентрация внедренных ионов остается постоянной и сохраняется
стабильное состояние матрицы.
Применения
Приложения
ВИМС можно разбить на пять широких (частично перекрывающихся) областей:
исследование поверхности, глубинные профили концентрации, распределение по
поверхности, микроанализ и анализ объема твердого тела.
Исследование
поверхности
В
области анализа поверхности ВИМС применяется в основном для
идентификации поверхностных атомов и молекул и для изучения динамики
поверхностных явлений. Кроме того, динамику поверхностных процессов можно
изучать, не внося заметных возмущений, поскольку для полного
анализа достаточно удалить всего лишь 10-6 внешнего атомного слоя
вещества. Методом ВИМС исследуются такие поверхностные явления, как
катализ, коррозия, адсорбция и диффузия.
В
приборах ВИМС, в которых предусмотрено все необходимое для напуска
газа и нагревания образцов, можно изучать поверхностные процессы in
situ. Информация, содержащаяся в масс-спектрах положительных и
отрицательных вторичных ионов, дает некоторое представление о
характере поверхностной связи и механизмах взаимодействия между
газом и поверхностью. К хорошо документированным применениям ВИМС
при изучении катализа относятся исследования разложения и синтеза
аммиака на железе и состава поверхностного слоя серебра, используемого
в качестве катализатора при окислении этилена. Каталитические процессы
отличаются от реакций окисления или коррозии металлов тем, что
активная зона каталитических реакций по размерам - порядка
моноатомного слоя, тогда как при окислении она увеличивается из-за
действия химических смещающих сил, направленных перпендикулярно
границе раздела между адсорбированным слоем и металлом. Предметом
ряда исследований, проведенных методику ВИМС, были начальные фазы
газовой коррозии и образования поверхностных соединений.
Извлечение
количественной информации о поверхностном слое или зоне реакции на поверхности
сопряжено с известными трудностями. Но как показано выше, процессы на
поверхности часто можно изучать и без приведения полученных данных к атомным
концентрациям частиц. Тип вторичных ионов и изменение их токов в зависимости от
времени, температуры и давления газа дают достаточную информацию для того,
чтобы судить о многих процессах, протекающих на поверхности образца.
Во многих случаях высокая чувствительность и широкие возможности
метода ВИМС компенсируют недостаточную количественную точность,
позволяя извлекать качественные или полуколичественные сведения
(особенно в плане качественного контроля при приготовлении и обработке
поверхности ), которые невозможно получить другими методами.
Глубинные
профили концентрации
ВИМС
- один из самых эффективных методов диагностики поверхности среди
применяемых для измерения распределения концентрации элементов по
глубине образца. Предел разрешения по глубине при таком методе не
превышает 50 А, а порог чувствительности меньше 1017 атом/см2.
В
настоящее время для изменения свойств приповерхностного слоя твердого тела
широко пользуются методам ионного внедрения (имплантации). Распределение
внедренных частиц по глубине определяют разными методами (радиоактивные
изотопы, измерение электропроводимости, рентгеновские лучи, возникающие при
бомбардировке тяжелыми ионами). Но применение подобных методов сопряжено с
большими трудностями и возможно далеко не при всех сочетаниях легирующий ион -
матрица. Метод ВИМС же свободен от таких ограничений и потому наиболее удобен
при определении профилей концентрации внедренных частиц.
Распределение
частиц по поверхности, микроанализ и объемный анализ
Рентгеновский
микроанализ открыл путь для диагностики твердых тел и до сегодняшнего
дня остается важнейшим методом такого анализа. Создание приборов
ВИМС типа масс-спектральнаго микроскопа и растрового микрозонда
расширило возможности микроанализа твердого тела, позволив достичь
большей чувствительности, проводить изотопический и поверхностный анализ
и обнаруживать присутствие элементов с малыми Z.
Масс-спектральные
микроскопы дают качественную, а при некоторых условиях и количественную
информацию о распределении элементов по поверхности образца. Они
применяются при изучении выделений на границах зерен, различных эффектов и
поли- и моно-кристаллах, диффузии (двумерного распределения в плоскости
поперечных шлифов), фазового состава минералов и распределения поверхностных
загрязнений.
Методом ВИМС проводится анализ двоякого рода: определение общего состава в
объеме твердого тела и определение состава в отдельных его точках (т. е
микрообластях диаметром менее 25 мкм). Микроанализ методом ВИМС проводился для
определения следов различных элементов, содержащихся в тех или иных зернах
минералов, изотопического анализа РЬ in situ в ореоле радиоактивных включений
(диаметром 1 - 2 мкм), элементного анализа взвеси и определения возраста
некоторых фаз в минералах по отношению 207Pb/206Pbи
рубидиево-стронциевым методом. Анализ активных газов (таких, как Н2,
N2, О2) в металлах этим методом сопряжен с известными
трудностями.
Заключение
Пока
что нет такого метода, который полностью удовлетворял бы всем запросам всех
исследователей, имеющих дело с поверхностью. Метод ВИМС не является исключением
в этом отношении, но он занимает особое положение в области анализа состава
объема и поверхности твердого тела, т. к. в ряде других отношений с ним не
могут сравниться никакие другие методы. Высокочувствительность к большинству
элементов, возможность регистрации атомов с малыми Z и изотопического анализа,
высокое разрешение по глубине при измерении профилей концентрации и возможность
изучения распределения элементов по поверхности делают ВИМС методом трехмерного
анализа изотопного и следового состава твердого тела (фиг. 14).
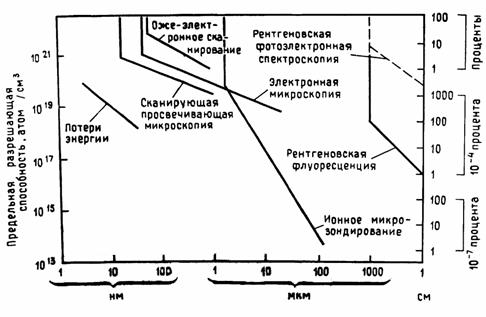
Фиг.14.
Влияние анализируемой площади на предельную разрешающую способность[2].
Многие
задачи физики поверхности могут быть решены качественными или
полуколичественными методами, поэтому, не очень высокая точность количественных
оценок, обеспечиваемая методом ВИМС, с лихвой компенсируется той ценной
качественной информацией, которую он дает. ВИМС уже оказал большое влияние на
микроанализ твердых тел в направлениях, имеющих как фундаментальное, так и
прикладное значение. Дальнейшее развитие метода ВИМС должно быть направлено,
главным образом, на решение проблемы количественного анализа и отыскания путей
повышения его точности.
Список литературы
1.
Мак-Хью И.А. Вторично-ионная масс-спектрометрия: В кн. Методы
анализа поверхности./Пер с англ. - М.: Мир,
1979. - с. 276-342.
2.
Броудай И., Мерей Дж. Физические основы микротехнологии: Пер. с англ. - М.: Мир,
1985. - 496 с.
3.
Технология СБИС: В 2-х кн. Пер. с англ./Под ред. С. Зи. - М.: Мир, 1986. - 453
с.
4.
Черепин В.Т., Васильев М.А. Методы и приборы для анализа поверхности материалов:
Справочник. - Киев: Наукова Думка, 1982. - 400 с.
5.
Фелдман Л., Майер Д. Основы анализа поверхности и тонких пленок./Пер. с англ.
- М.: Мир, 1989. - 342 с.
6.
Добрецов Л.Н., Гомоюнова М.В. Эмиссионная электроника. - М.: Наука, 1966.
- 564 с.
7.
Векслер В.И. Вторичная ионная эмиссия металлов. - М.: Наука, 1978. - 240 с.
Copyright © Radioland. Все права защищены.
Дата публикации: 2004-09-01 (570 Прочтено) | 
 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50

 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50