Студентам > Курсовые > Вторично-ионная масса спектрометрия
Вторично-ионная масса спектрометрияСтраница: 2/5
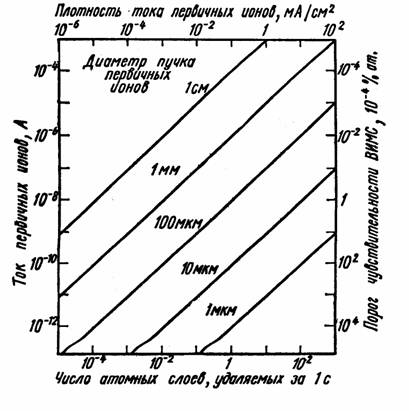
Фиг.
Зависимость между током первичных ионов, диаметром и плотностью первичного
пучка,
скоростью удаления атомных слоев и порогом чувствительности ВИМС[1].
Распыление
ионным пучком - разрушающий процесс. Но если требуется, чтобы
поверхность оставалась практически без изменения, то анализ методом
ВИМС можно проводить при очень малых скоростях распыления образца
(менее 10-4 монослоя в секунду) . Чтобы при этом обеспечить
достаточную чувствительность метода ( »10-4
монослоя), как видно из фиг.5, необходим первичный ионный пучок с током 10-10
А диаметром 1 мм. При столь низкой плотности тока первичных ионов (
10-5 мА/см2) скорость поступления на поверхность
образца атомов или молекул остаточных газов может превысить скорость их
распыления первичным пучком. Поэтому измерения методом ВИМС в таких
условиях следует проводить в сверхвысоком или чистом (криогенном) вакууме.
Указанные
приборные условия приемлемы не во всех случаях анализа. Например,
определение профиля концентрации примесей, присутствующих в малых
количествах в поверхностной пленке толщиной свыше 5ОО А, удобно проводить
при диаметре пучка, равном 100 мкм, и при скорости распыления, превышающей
10-1 атомных слоев в секунду. Еще более высокие плотности
ионного тока требуются, чтобы обеспечить статистически значимые количества
вторичных ионов с единицы площади поверхности, необходимые при
исследовании распределения по поверхности следов элементов при помощи ионного
микрозонда или масс-спектрального микроскопа. На основании сказанного и данных
фиг.5 мы заключаем, что невозможно обеспечить поверхностное разрешение в
несколько микрометров для примеси, содержание которой равно »10-4%, при скорости распыления менее 10-3
атомных слоев в секунду. Это взаимно исключающие условия.
Методом
ВИМС анализ поверхности можно проводить в двух разных режимах: при малой и
большой плотности тока, распыляющего образец. В режиме малой плотности
распыляющего тока изменяется состояние лишь малой части поверхности, благодаря
чему почти выполняется основное требование, предъявляемое к методам анализа
самой поверхности. В режиме же высоких плотностей токов и соответствующих
больших скоростей распыления проводится измерение профилей распределения
элементов по глубине, микроанализ и определение следовых количеств элементов
(<10-4%). В соответствии со всеми этими вариантами создан ряд
приборов ВИМС, в которых применяются разные способы создания и фокусировки
первичных ионных пучков и разные анализаторы вторичных ионов.
Оборудование ВИМС.
Установка ВИМС состоит из четырех основных блоков: источника
первичных ионов и системы формирования пучка, держателя образца и
вытягивающей вторичные ионы линзы, масс-спектрометра для анализа
вторичных частиц по отношению массы к заряду (m/е) и
высокочувствительной системы регистрации ионов. Для получения
первичных ионов в большинстве установок используются газоразрядные
или плазменные источники. Совместно с соответствующей системой
формирования и транспортировки пучка эти источники обеспечивают
широкие пределы скорости распыления поверхности - от 10-5 до
103 А/с. Разделение вторичных частиц по m/е производится
либо магнитными, либо квадрупольными анализаторами. Наиболее
широко распространенным анализатором в установках ВИМС, очень
удобным при анализе состава образцов и обнаружении малых количеств
(следов) элементов в них, является магнитный спектрометр с двойной
фокусировкой (в котором осуществляется анализ по энергии и по импульсу),
что связано с его высокой чувствительностью к относительному
содержанию. Для таких многоступенчатых магнитных спектрометров
фоновый сигнал, возникающий из-за хвостов основных пиков материала
матрицы (рассеяние стенками, на атомах газа и т.д.), может быть
сведен к уровню менее 10-9 для общего фона и всего 10-6
для масс, близких к основному пику. Все же в отдельных конкретных
случаях более практичным может оказаться менее дорогой
квадрупольный
анализатор.
Принцип
действия установок.
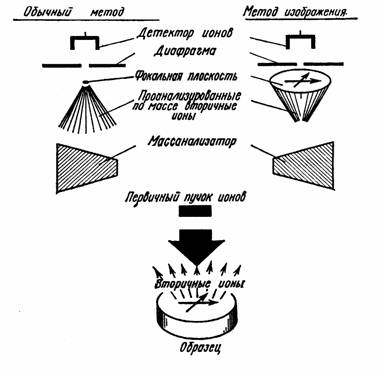
Фиг.6.
Схема обычного метода и метода прямого изображения при
масс-
спектрометрическом анализе вторичных ионов[1].
При
масс-анализе вторичных ионов применяются два основных метода: обычный
масс-спектрометрический и метод прямого изображения. Они схематически
сопоставлены на фиг.6. При первом методе анализатор с хорошим разрешением
передает на высокочувствительный ионный детектор заметную часть быстрых
вторичных ионов, идущих с большой площади образца (» 1 мм2). Выделенные по массе вторичные частицы собираются в
точечный фокус на входной щели детектора. В этом статическом случае получаемая
информация усредняется по поверхности образца и невозможно установить, из какой
точки (например области диаметром 1 мкм) поверхности приходят вторичные ионы.
При методе прямого изображения в фокальной плоскости анализатора создается
стигматическое ионное изображение поверхности и путем соответствующего
дифрагмирования (или преобразования изображения при помощи чувствительной к
электронам или ионам эмульсии) легко можно получить информацию о точках выхода
ионов с данными m/e с поверхности образца.
Все
установки с прямым изображением основан на идее прибора Кастэна и Слодзяна;
все иные приборы представляют собой варианты обычной масс-спектрометрической
методики. Для получения вторично-ионного изображения поверхности при обычном
подходе необходимо проводить последовательный анализ вторичных частиц при
сканировании поверхности
мишени
первичным ионным пучком малого диаметра. При этом для получения изображения
мишени на экране электронно-лучевой трубки (ЭЛТ) проще электрически сканировать
первичный пучок, нежели механически перемещать сам образец. Электронный луч в
ЭЛТ синхронизирован с первичным ионным пучком, и усиленным сигналом
вторично-ионного детектора модулируются интенсивность электронного луча в ЭЛТ.
Получаемое при таком методе увеличение изображения равно отношению длины строки
на экране ЭЛТ к расстоянию на поверхности образца, пробегаемому первичным
ионным пучком в процессе сканирования.
Все
установки ВИМС позволяют осуществлять анализ поверхности и распределения
концентрации элемента по глубине. Они различаются в таких важных отношениях,
как порог чувствительности при детектировании, разрешение по массам, плотности
тока первичного пучка, вакуумные условия в окрестности мишени, а также
возможность проведения анализа распределения элементов по поверхности, или
топографического (x-y) анализа, путем сканирования зондом или формирования
изображения. К устройствам для топографического анализа относят лишь те,
которые позволяют получить разрешение по поверхности не хуже 10 мкм. Все существующие
установки ВИМС можно разделить на три группы в соответствии с принципом их
устройства и пригодностью для микроанализа:
· не позволяющие осуществлять анализ распределения
элементов по поверхности;
· дающие сведения о распределении по поверхности с помощью
сканирующего ионного зонда;
· дающие сведения о распределении по поверхности методом
прямого изображения.
Установки,
не обеспечивающие анализа распределения частиц по поверхности
Ряд
вторично-ионных масс-спектрометров был сконструирован для решения частных
аналитических проблем или исследования различных закономерностей вторичной
ионной эмиссии.
Использованные
на ранней стадии исследований этого явления анализаторы с однократной
фокусировкой (секторные магниты) имели весьма ограниченное разрешение по массам
и низкую чувствительность, что было обусловлено большим разбросом начальных
энергий вторичных ионов.
В
настоящее время большое внимание уделяется квадрупольным
анализаторам, поскольку они, будучи просты и недороги, позволяют получать
сведения о поверхности и профиле концентрации примеси почти во всех
случаях, когда не требуется информации о распределении по поверхности
или очень малых количествах примеси. Добиться снижения фона при работе с
квадрупольным фильтром масс можно за счет предварительной селекции
вторичных ионов плоскопараллельным электростатическим анализатором с малой
диафрагмой, а также внеаксиального расположения ионного детектора.
Установки,
позволяющие получать сведения о распределении элемента по поверхности, со
сканирующим ионным зондом
Установки
ВИМС, относящиеся к этой категории, обычно называют ионными зондами. В этих
установках первичный пучок анализируется по массам и может быть сфокусирован в
пятно диаметром от 2 и менее до 300 мкм. Масс-спектрометр представляет собой
устройство с двойной фокусировкой и хорошим пропусканием частиц, позволяющее
давать стигматическое изображение при среднем разрешении по массам. Схема
такого прибора приведена на фиг.7.

Фиг.7.
Схема ионного микрозонда[4].
Установки
с прямым изображением
Первой
установкой ВИМС, которая позволила получить изображение объекта в лучах
выделенных по m/е ионов и визуально наблюдать распределение элемента по
поверхности, был масс-спектральный микроскоп, его схема представлена на фиг.8.
Уникальная особенность масс-спектрального микроскопа - возможность наблюдать за
интенсивностью вторичных ионов со специально выделенного микроучастка
поверхности независимо от размеров и местоположения первичного пучка, пока хотя
бы часть его попадает на интересующий нас участок поверхности. Эта возможность
является ценной в некоторых случаях анализа методом ВИМС распределения
элементов по поверхности и в объеме. Ниже будут рассмотрены некоторые из
наиболее важных преимуществ, а также и недостатков, свойственных различным
типам приборов.
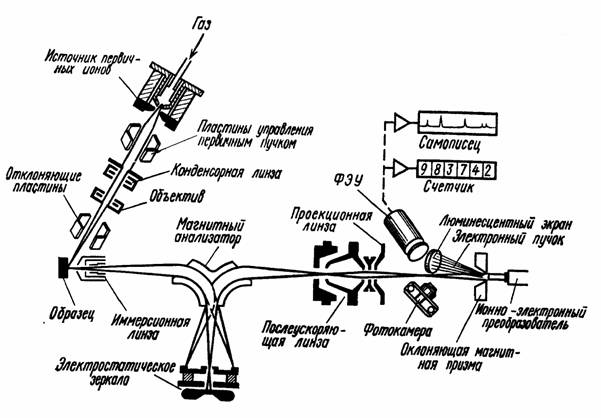
Фиг.8.
Схема масс-спектрального ионного микроскопа[4].
Порог
чувствительности
Минимально
обнаружимый уровень содержания элемента в данной матрице зависит от свойств
самого элемента, химического состава матрицы, в которой он присутствует, сорта
первичных ионов, их тока, попадающего на образец, телесного угла отбора
частиц и эффективности прохождения вторичных ионов через анализатор, его
общего фона, а также фона и эффективности детектора. Все перечисленные
факторы, кроме двух первых, определяются конструкцией прибора и,
следовательно, могут быть оптимизированы с целью достижения наиболее
высокой чувствительности. Поскольку распыление является разрушающим
процессом, для минимизации количества потребляемого материала
необходимы высокоэффективные анализаторы и высокая чувствительность.
Ввиду того что различные конструкции установок ВИМС предназначены
либо для выявления тех или иных отдельных особенностей, либо для
обеспечения наибольших удобств измерений, они весьма сильно различаются
по чувствительности. Удобной мерой чувствительности может служить
отношение числа регистрируемых вторичных ионов к числу первичных при
неких стандартных условиях: образец, сорт первичных частиц и
некоторое минимальное разрешение по массе. Установки ВИМС,
позволяющие регистрировать »106 ион/с
характерного элемента из оксидной матрицы (например, ионы Fe+
из образца Fe2O3) при токе первичного пучка 10-9
А, классифицируются как имеющие чувствительность, достаточную для
обнаружения следов элементов и для микроанализа
поверхности.
Химический
состав матрицы образца оказывает непосредственное влияние на порог
чувствительности для тех или иных элементов и является основным
источником неконтролируемых изменений этой величины. Матрица влияет на порог
чувствительности двояким образом: от нее зависит коэффициент SA± из-за различий в электронных свойствах материалов,
и она может давать нежелательные молекулярные и многозарядные ионы,
которые окажутся в масс-спектре в диапазоне масс, интересующем
исследователя. Но число молекулярных ионов быстро уменьшается с ростом
числа атомов, входящих в состав молекулы, и в большинстве случаев при
концентрациях элемента, не превышающих 10-4, особых сложностей
в связи с наложениями пиков не возникает.

Фиг.9. Участок масс-спектра
вторичных ионов
флюорапатита
вблизи массы 43 при разном разрешении по массам: а-300; б-1000;
в-3000[1].
Перекрытие пиков от атомарных и молекулярных
ионов можно выявить двумя способами: путем анализа быстрых вторичных ионов
или применением анализаторов по m/е с разрешением М/DМ > 3000. В первом случае коэффициент ионной эмиссии
уменьшается примерно во столько же раз, во сколько коэффициент выбивания
молекулярных ионов уменьшается по сравнению с атомарными. В некоторых
случаях этот метод вполне приемлем; но при решении
многочисленных
задач обнаружения следов примесей или микроанализа поверхности
недопустимо большое снижение чувствительности характерное для этого метода.
Второй способ является более прямым и с точки зрения анализа более
предпочтителен. Чтобы выявить сложную структуру отдельных пиков в
масс-спектрах используют для ВИМС приборы с высоким разрешением по массе. На фиг.9,
представлена форма пика с массой 43 ат. ед. при разных разрешениях анализатора.
Высокое разрешение очень важно для уменьшения или исключения в идентификации
пиков m/е, особенно если основной целью является обнаружение следов элементов
на уровне атомных концентраций, не превышающих 10-5.
Вопрос
о пороге чувствительности метода ВИМС для различных элементов исследовался
многими авторами как теоретически, так и на основе результатов
экспериментальных измерений. При этом были получены следующие примерные
значения, подтвердившиеся в некоторых строго определенных условиях: менее 10-7
моноатомного слоя, атомная концентрация 10-9 и менее 10-18
г элемента. Но эти значения характерны лишь для некоторых частных случаев и не
являются нормой на практике. Обычно мы имеем дело со сложными спектрами с
многократными наложениями линий, в силу чего порог чувствительности оказывается
сильно зависящим от природы матрицы образца. Поэтому, указывая порог
чувствительности, необходимо указывать и соответствующие дополнительные
факторы, в частности тип матрицы, и не следует делать огульные утверждения
относительно того или иного элемента.
Если
пренебречь возможным перекрытием пиков, то порог чувствительности для
некоторого элемента в матрице обратно пропорционален току первичных ионов IP,
попадающему на образец. На фиг.5 и 10 показано, как
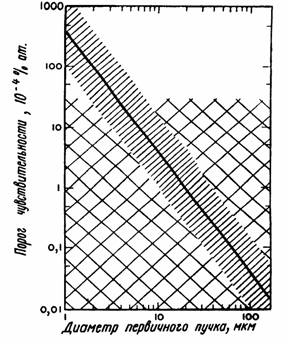 Фиг.10. Зависимость
порога чувствительности типичного прибора ВИМС от диаметра первичного
ионного пучка[1]. Фиг.10. Зависимость
порога чувствительности типичного прибора ВИМС от диаметра первичного
ионного пучка[1].
изменяется
порог чувствительности в зависимости от различных параметров, влияющих на ток
первичных ионов. Приведенные здесь значения порога чувствительности основаны на
экспериментальных данных, полученных в типичных для анализа условиях, когда
первичными частицами служат ионы О2+. Область с простой
штриховкой на фиг.10 вблизи линии 5 мА/см2 соответствует диапазону
плотностей токов первичных частиц, обычно применяемых в установках типа
ионного микрозонда или масс-спектрального микроскопа. Область с двойной
штриховкой отвечает условиям, при которых существенно наложение линий сложных
молекулярных ионов, и необходимо позаботиться об идентификации пиков по m/е.
Истинное положение или высота этой области зависит как от матрицы образца, так
и от разрешения по массам и чувствительности масс-анализатора. Для
| 
 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50

 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50