Студентам > Курсовые > Вторично-ионная масса спектрометрия
Вторично-ионная масса спектрометрияСтраница: 3/5
микроанализа
поверхности, т.е. исследования областей диаметром <3 мкм, методами ионного
зонда или масс-спектрального микроскопа минимально детектируемый уровень
сигнала выше уровня, при котором становится важным перекрывание пиков
молекулярных ионов (фиг. 10); следовательно, если требуется осуществить только
общий анализ малых участков твердого тела, то высокое разрешение по массам
не обязательно. Если же интересоваться следами элементов в сложных
матрицах, то необходимо иметь масс-анализатор с высоким разрешением по
массам.
Анализ
следов элементов
Предполагаемый
порог чувствительности метода ВИМС для многих элементов близок к 10-9.
Но для обеспечения общего порога чувствительности такого порядка на практике
необходимо использовать (как видно из сказанного выше) масс-апализаторы с
высоким разрешением и высокой чувствительностью к относительному
содержанию и, кроме того, контролировать ряд эффектов, о которых говорится
ниже.
Большая
часть вторичных ионов выходит из нескольких наружных атомных слоев
твердого тела, а поэтому вещество, адсорбированное на поверхности,
выступает в спектре как важный компонент твердого тела или его
поверхности. Среда, окружающая образец, обычно содержит молекулы
углеводородов, Н2, N2, О2, Н2О, СО2
и СО. Поэтому обнаружение в матрице следов таких элементов, как С, N, Н
и О, оказывается весьма сложным в том случае, если не приняты
специальные меры для сведения к минимуму их влияния. Меры эти таковы:
проведение измерений в сверхвысоком вакууме, свободном от
углеводородов, применение криогенной и геттерной откачки объема
вблизи образца и работа при высоких плотностях тока первичных ионов, при
которых скорость удаления поверхностных слоев в результате распыления намного
больше скорости поступления частиц загрязнений. При давлении 10-8 мм
рт. ст. скорость прихода на мишень атомов или молекул остаточных газов
приблизительно равна скорости поступления ионов первичного пучка с плотностью
тока - 10 мА/см2.
Источниками
загрязнений служат также поверхности , расположенные вблизи мишени, на которые
попадает значительное количество распыленного вещества. Часть этого вещества в
результате испарения или распыленная вторичными и отраженными ионами может
возвращаться на мишень. Это так называемый “эффект памяти”, и его значение в
конкретном анализе зависит от предыстории образца. Данный эффект наиболее
значителен в приборах, где используются большие токи первичных ионов, а
вытягивающие линзы расположены вблизи поверхности изучаемого образца.
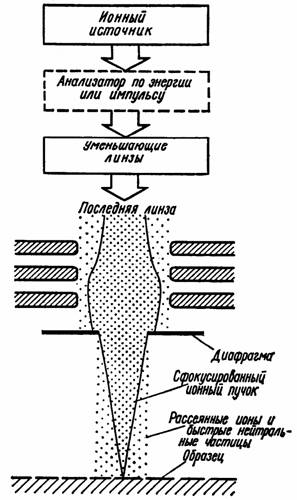
Фиг.11. Компоненты
сфокусированного ионного пучка, связанные с рассеянными ионами и
нейтральными атомами[1].
Чтобы предупредить внедрение в образец того элемента, содержание которого
определяется, особенно важна химическая чистота первичного ионного пучка. При
типичных условиях (скорость распыления образца, пробел и разброс по пробегам
первичных ионов) и в предположении, что распыление продолжается достаточно,
долго, для того чтобы воздействовать на уже легированную зону, а основным
источником ионов примеси является обратное распыление ранее внедренных частиц,
присутствие в первичном ионном пучке 10-6 загрязнений должно
проявиться как объемная примесь с атомной концентрацией ~10-7. Чтобы
гарантировать чистоту первичного ионного пучка и исключить возможность
осложнений на уровне следов элементов, желательно осуществлять сепарацию пучка
первичных ионов по массе.
Чтобы
уменьшить влияние загрязнения поверхности остаточными газами, при анализе
объемного состава твердого тела обычно пользуются первичными ионными пучками с
высокой плотностью тока. При этом область
малой
плотности тока, т.е. периферийная часть пучка, дает основной вклад во
вторично-ионный сигнал того элемента, который присутствует одновременно как
в остаточном газе, так и в твердом теле в виде микропримеси. К подобному
эффекту может привести не только загрязнение атомами остаточных газов (обычно
наиболее существенное), но и любые иные источники поверхностных загрязнений,
действующие во время измерений. Для установок ВИМС, основанных на обычной
методике масс-спектрометрии, указанная проблема более важна, чем для
масс-спектральных микроскопов. В последнем случае можно в плоскости изображения
поместить вырезающую диафрагму так, чтобы отбирать лишь ионы, выходящие из
средней, эффективно распыляемой части мишени, где равновесная поверхностная
концентрация адсорбированных загрязнений минимальна.
Другой
эффект, в известной мере аналогичный рассмотренному выше эффекту периферийной
области пучка, поясняется схемой, представленной на фиг.11. Он связан с
облучением большой площади образца быстрыми нейтральными атомами,
образующимися в результате перезарядке при столкновениях первичных ионов с
атомами, а также рассеянными ионами, возникающими при фокусировке первичного
ионного пучка на мишень. Размер облучаемой этими частицами области определяется
ограничивающими диафрагмами на пути ионного пучка и обычно превышает 250 мкм.
Роль этого эффекта зависит от давления остаточных газов, конструкции линз,
расположения и размеров диафрагм и геометрического устройства электродов
колонны. Такая несфокусированная часть облучающего мишень потока
непосредственно не зависит от сфокусированного ионного тока, поступающего на
образец, но в основной своей части определяется полным потоком ионов в
колонне.
В
микрозондовом варианте метода ВИМС эти эффекты гораздо более серьезны, нежели в
масс-спектральных микроскопах. Но к существенным ошибкам при анализе с
применением микрозонда они приводят только в том случае, когда большая площадь,
облучаемая несфокусированной частью пучка, замет но отличается по составу от
анализируемой точки. При диаметре пучка, равном нескольким микрометрам,
несфокусированный компонент может облучать большую площадь поверхности образца
и составлять более 1% ионного потока. Особенно неблагоприятные условия
возникают, если детали колонны формирования первичного пучка (ионный источник,
линзы, отражатель, диафрагмы) размещены на одной оси, пересекающейся с
осью анализатора вторичных частиц. Этот эффект можно сильно ослабить,
если отклонить первичный пучок от оси прибора и диафрагмировать его вблизи
самого образца.
Другой
метод, пригодный при объемном анализе в условиях, когда поверхность
образца неоднородна по составу или загрязнена элементами, присутствие
которых в объеме и исследуется, заключается в нанесении на поверхность
пленки слоя высокочистого углерода (или другого элемента, отсутствующего в
объеме и не представляющего интереса в проводимою анализе) толщиной 200 -
500 А. В анализируемой точке этот слой может быть легко удален первичным
пучком большой плотности. В то же время “хвост” малой плотности тока на
краях пучка и несфокусированные компоненты первичного пучка будут попадать
на поверхность из чистого углерода, и, следовательно, области поверхности,
отличные от центральной, не дадут какого-либо вклада в сигнал.
Ионное
изображение
Вторично-ионное
изображение, дающее двумерную картину размещения элемента по
поверхности, может быть получено либо методом масс-спектрального
микроскопа, либо методом сканирующего микрозонда. В масс-спектральных
микроскопах разрешение по поверхности не зависит от размеров первичного ионного
пучка; оно определяется аберрациями оптики анализатора вторичных ионов и
хроматическими аберрациями, обусловленными разбросом вторичных ионов по
энергиям. Если улучшать разрешение введением фильтра энергий, то снижается
“светосила” прибора (число регистрируемых вторичных ионов, приходящихся на
одну первичную частицу). В масс-спектралъных микроскопах достигнуто
поверхностное разрешение ~1 мкм.
В
приборах со сканирующим микрозондом поверхностное разрешение ограничено
диаметром первичного пучка, а потому определяется качеством системы,
фокусирующей первичный пучок. При высокой степени фокусировки (пучки диаметром
менее 1 мкм) значительный вклад в полный поток первичных частиц, падающих
на образец, может составить несфокусированный компонент и, следовательно,
должны быть приняты меры для его устранения. Светосила прибора такого
типа остается постоянной при любом поверхностном разрешении, так как
она определяется анализатором вторичных ионов, а не размерами первичного
пучка. В микрозондовых приборах было достигнуто разрешение 1 - 2 мкм.
Предельное разрешение, которое можно надеяться получить в приборах с
вторичной ионной эмиссией, - порядка 100 А. Это ожидаемое значение -
физический предел, обусловленный характеристиками каскадов столкновений,
перемешиванием в приповерхностных слоях, вызываемым первичными ионами, и
средней глубиной выхода вторичных ионов. Однако практически из-за ограниченной выходной
интенсивности источника первичных ионов и недостаточно высокого качества оптики
электростатических линз нижний предел размеров ионного пучка оказывается ~
1000 А.
При
одинаковом поверхностном разрешении и при одинаковых плотностях первичного тока
масс-спектральный микроскоп требует для получения ионного изображения большой
площади (например, 200 Х 200 мкм2) меньше времени, чем сканирующий
микрозонд. Дело в том, что в микроскопе информация собирается одновременно от
всех точек поверхности, а не последовательно от точки к точке. Но если
интересоваться малыми участками (20 Х 20 мкм2), то время
формирования изображения, получаемого при помощи микрозонда, оказывается таким
же, как и в масс-спектральном микроскопе, или даже меньшим. Это объясняется
большим усилением в регистрирующей системе микрозондовых устройств (электронный
умножитель и ЭЛТ с модуляцией яркости) и сравнительно низкой чувствительностью
фотоэмульсий, применяемых для регистрации изображений.
При
анализе малых площадей сканирующий микрозонд дает еще два преимущества: меньше
участок поверхности, испытывающий возмущение, а изображение, получаемое на
экране ЭЛТ, сразу же пригодно для анализа.
Требования
к первичному ионному пучку
Первичный
ионный пучок играет очень важную роль в приборах ВИМС; поэтому целесообразно
остановиться на некоторых желаемых характеристиках пучка и системы его
формирования, о которых ранее не говорилось. Эта система должна создавать
сфокусированный и стабильный пучок ионов инертного газа (например, Аг+),
а также положительных и отрицательных ионов химически активного газа (например,
О2+ и О-). Ионы активных газов нужны при
объемном анализе твердого тела, а при облучении отрицательными ионами
снижается роль зарядки поверхности.
Накопление
заряда на поверхности зависит от рода первичных ионов, их заряда, энергии и
плотности тока, размеров облучаемой области, а также проводимости и толщины
слоя диэлектрика. Локальные изменения потенциала поверхности могут вызывать ряд
нежелательных эффектов: смещение пучка, миграцию элементов в имплантированной
зоне, а также изменение энергии вторичных ионов и уменьшение эффективности их
собирания вследствие искажения вытягивающего ионы поля в непосредственной близости
от поверхности образца. Расчет влияния зарядки поверхности на траектории
вторичных ионов, выбиваемых из диэлектриков.
В
ВИМС существует несколько способов уменьшения образования положительного заряда
на поверхности: облучение ее широким потоком электронов, которые эмитируются
расположенным неподалеку термокатодом, облучение пучками отрицательных ионов,
повышение давления кислорода вблизи образца до 10-4 мм рт.
ст. При исследовании объема диэлектриков (в отличие от тонких диэлектрических
пленок на проводнике) для эффективного отбора вторичных ионов в анализатор
необходимо создать между образцом и электродом, вытягивающим вторичные ионы,
надлежащий градиент электрического поля. С этой целью на поверхность
диэлектрика наносят проводящую пленку или накладывают металлическую
сетку.
Газоразрядные
источники, используемые обычно для получения первичных ионов, сильно повышают
давление газов в объеме прибора; поэтому крайне желательно предусмотреть
дифференциальную откачку системы формирования пучка. Сепарация первичных ионов
по массам важна для очистки пучка, но не только от инородных элементов, а и
от молекулярных частиц, что необходимо для определения характеристик
каскадов столкновений и их влияния на разрешение по глубине и перемешивание
атомов в приповерхностном слое. Кроме того, система формирования первичного
пучка должна позволять развертывать его в растр для однородного
распределения первичного потока по поверхности, что необходимо при изучении
профилей концентрации примеси. Наконец, при анализе микрообластей
желательно иметь возможность визуально наблюдать за поверхностью образца
вблизи места попадания ионного пучка посредством высококачественной
оптической системы с большим увеличением.
Масс-спектрометрический
анализ нейтральных распыленных частиц
При
распылении большинства материалов доля частиц, выходящих из мишени в виде
нейтральных атомов, значительно выше, чем выходящих в виде ионов. Поэтому
естественным развитием и дополнением ВИМС является метод ионизации и
последующего анализа выбитых нейтральных частиц. Такой метод получил название
масс-спектрометрии ионизованных нейтральных атомов. Одним из его преимуществ
является то, что нейтральные частицы можно ионизовать за счет такого процесса,
который, не зависит ни от матрицы, ни от свойств поверхности образца. Основные
же недостатки масс-спектрометрии ионизованных нейтральных атомов - то,
что ионизуются все частицы, присутствующие в газовой среде прибора, а
эффективность отбора ионизованных частиц в анализатор значительно меньше,
чем в ВИМС. Если доля ионов среди выбитых вторичных частиц gA± превышает
10-4 (что выполняется для большинства элементов и матриц), то
масс-спектрометрия ионизованных нейтральных атомов не может конкурировать
с ВИМС по абсолютной чувствительности SA±.
Нейтральные
частицы, выбитые из мишени газовыми ионами из разряда, ионизуются вслед
за тем электронным ударом; путем перезарядки или за счет пеннинговского
процесса газоразрядной плазме. Чувствительность метода и целесообразность
его применения зависят от эффективности отбора образовавшихся ионов и от
того, оптимизованы ли условия разряда так, чтобы вероятность ионизации
анализируемых нейтральных частиц была больше вероятности ионизации всех
других частиц газового разряда.
Исследование
распыления и ионизации нейтральных атомов в высокочастотном разряде в
инертных газах показало, что такой метод имеет практическую ценность. Разброс
по энергиям, ионов, отбираемых из источника с высокочастотным тлеющим разрядом,
не превышает 1 эВ, и для их разделения по массам эффективно использовать
квадрупольный анализатор без предварительного фильтра энергий. Установлено, что
нейтральные атомы ионизуются в основном за счет пеннинговского механизма.
Эффективность ионизации нейтральных частиц в этом случае лишь слабо зависит от
природы частиц и совсем не зависит (в противоположность методу ВИМС) от типа
матрицы и условий на поверхности образца. Следовательно, относительные ионные
сигналы с достаточно хорошим приближением равны относительным концентрациям
соответствующих элементов в матрице. При использовании образцов с большой
поверхностью ( ~10 см2) в этом приборе удалось регистрировать
атомные концентрации элементов на уровне 10-6. Типичные значения
скоростей распыления лежат в интервале от 10-2 до 10 моноатомных
слоев в секунду, причем с равным успехом могут анализироваться как проводники,
так и диэлектрики. Таким образом, не давая сведений о распределении
вещества по поверхности, метод масс-спектрометрии тлеющего разряда
позволяет определять химический состав поверхности и объема, а также дает
возможность измерять распределение элемента по глубине. Метод имеет ряд
привлекательных особенностей, которые делают целесообразным его
дальнейшее развитие.
Количественный анализ
Коэффициент
вторичной ионной эмиссии SA±
зависит от целого ряда факторов, таких, как состояние поверхности образца,
природа его матрицы, и различных эффектов, вызываемых первичным пучком.
Следовательно, сопоставление интенсивностей вторичных ионов данного
элемента из различных точек поверхности образца не всегда непосредственно
отражает распределение этого элемента по поверхности. При оценке такого
рода данных и особенно при интерпретации ионного изображения поверхности
необходимо соблюдать осторожность.
Эти
изменения вызваны эффектами, зависящими от химической природы и кристаллической
структуры материала, а также от относительной ориентации зерен на поверхности.
К таким эффектам относятся каналирование первичных ионов, индуцированная
облучением рекристаллизация, различия в концентрации внедренного кислорода и
различия в угловом распределении вторичных ионов, выбитых из по-разному
ориентированных зерен сплава. Относительные изменения интенсивности ионов при
переходе от одного зерна к другому приблизительно одинаковы для всех элементов.
Если измеряемые интенсивности в каждой точке отнести к интенсивности ионов
основного элемента, то разница между зернами сглаживается или совсем исчезает.
Наблюдения такого рода показывают, что любые количественные оценки следует
основывать не на абсолютных значениях коэффициента SA±, а на относительных значениях выхода различных
ионов из анализируемой
точки.
|

 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50

 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50